Código QR

Sobre nosotros
Productos
Contáctenos

Teléfono

Fax
+86-579-87223657

Correo electrónico

DIRECCIÓN
Wangda Road, Ziyang Street, condado de Wuyi, ciudad de Jinhua, provincia de Zhejiang, China
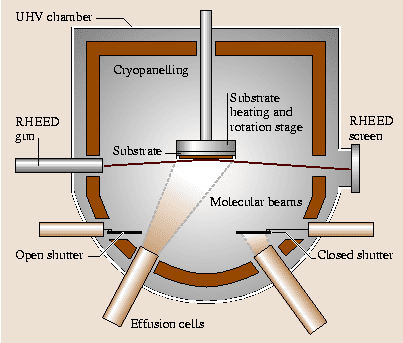
Un horno epitaxial es un dispositivo utilizado para producir materiales semiconductores. Su principio de funcionamiento es depositar materiales semiconductores sobre un sustrato a alta temperatura y alta presión.
El crecimiento epitaxial de silicio consiste en hacer crecer una capa de cristal con buena integridad de la estructura reticular sobre un sustrato monocristalino de silicio con una cierta orientación cristalina y una resistividad de la misma orientación cristalina que el sustrato y diferente espesor.
● crecimiento epitaxial de una capa epitaxial alta (baja) de resistencia en sustrato de resistencia baja (alta)
● Crecimiento epitaxial de la capa epitaxial tipo N (P) sobre sustrato tipo P (N)
● Combinado con la tecnología de máscaras, el crecimiento epitaxial se realiza en un área especificada
● El tipo y la concentración de dopaje se pueden cambiar según sea necesario durante el crecimiento epitaxial.
● Crecimiento de compuestos heterogéneos, multicapa y multicomponente con componentes variables y capas ultrafinas.
● lograr el control de espesor de tamaño atómico a nivel atómico
● Cultivar materiales que no se pueden convertir en cristales individuales.
Los componentes discretos de semiconductores y los procesos de fabricación de circuitos integrados requieren tecnología de crecimiento epitaxial. Debido a que los semiconductores contienen impurezas de tipo N y tipo P, a través de diferentes tipos de combinaciones, los dispositivos semiconductores y los circuitos integrados tienen diversas funciones, que se pueden lograr fácilmente mediante el uso de tecnología de crecimiento epitaxial.
Los métodos de crecimiento epitaxial de silicio se pueden dividir en epitaxia de fase de vapor, epitaxia de fase líquida y epitaxia de fase sólida. En la actualidad, el método de crecimiento de deposición de vapor químico se usa ampliamente internacionalmente para cumplir con los requisitos de integridad de cristal, diversificación de la estructura del dispositivo, dispositivos simples y controlables, producción por lotes, garantía de pureza y uniformidad.
La epitaxia de fase de vapor vuelve a crecer una sola capa de cristal en una sola oblea de silicio de cristal, manteniendo la herencia de la red original. La temperatura de la epitaxia de la fase de vapor es más baja, principalmente para garantizar la calidad de la interfaz. La epitaxia de fase de vapor no requiere dopaje. En términos de calidad, la epitaxia de la fase de vapor es buena, pero lenta.
El equipo utilizado para la epitaxia química en fase de vapor suele denominarse reactor de crecimiento epitaxial. Generalmente se compone de cuatro partes: un sistema de control de la fase de vapor, un sistema de control electrónico, un cuerpo del reactor y un sistema de escape.
Según la estructura de la cámara de reacción, hay dos tipos de sistemas de crecimiento epitaxial de silicio: horizontal y vertical. El tipo horizontal rara vez se usa, y el tipo vertical se divide en tipos de placa plana y barril. En un horno epitaxial vertical, la base gira continuamente durante el crecimiento epitaxial, por lo que la uniformidad es buena y el volumen de producción es grande.
El cuerpo del reactor es una base de grafito de alta pureza con un tipo de barril de cono poligonal que ha sido tratado especialmente suspendido en una campana de cuarzo de alta pureza. Las obleas de silicio se colocan en la base y se calientan de manera rápida y uniforme con lámparas infrarrojas. El eje central puede girar para formar una estructura estrictamente resistente al calor y a prueba de explosión.
El principio de trabajo del equipo es el siguiente:
● El gas de reacción ingresa a la cámara de reacción desde la entrada de gas en la parte superior de la campana, sale de seis boquillas de cuarzo dispuestas en círculo, es bloqueado por el deflector de cuarzo y se mueve hacia abajo entre la base y la campana, reacciona a alta temperatura y se deposita y crece en la superficie de la oblea de silicio, y el gas de cola de reacción se descarga en el fondo.
● Distribución de temperatura 2061 Principio de calentamiento: una alta frecuencia y alta corriente pasa a través de la bobina de inducción para crear un campo magnético de vórtice. La base es un conductor, que se encuentra en un campo magnético de vórtice, generando una corriente inducida, y la corriente calienta la base.
El crecimiento epitaxial de la fase de vapor proporciona un entorno de proceso específico para lograr el crecimiento de una capa delgada de cristales correspondientes a la fase de cristal único en un solo cristal, lo que hace preparaciones básicas para la funcionalización del hundimiento de cristal único. Como proceso especial, la estructura cristalina de la capa delgada cultivada es una continuación del sustrato de cristal único y mantiene una relación correspondiente con la orientación cristalina del sustrato.
En el desarrollo de la ciencia y la tecnología de los semiconductores, la epitaxia en fase de vapor ha desempeñado un papel importante. Esta tecnología se ha utilizado ampliamente en la producción industrial de dispositivos semiconductores y circuitos integrados de Si.
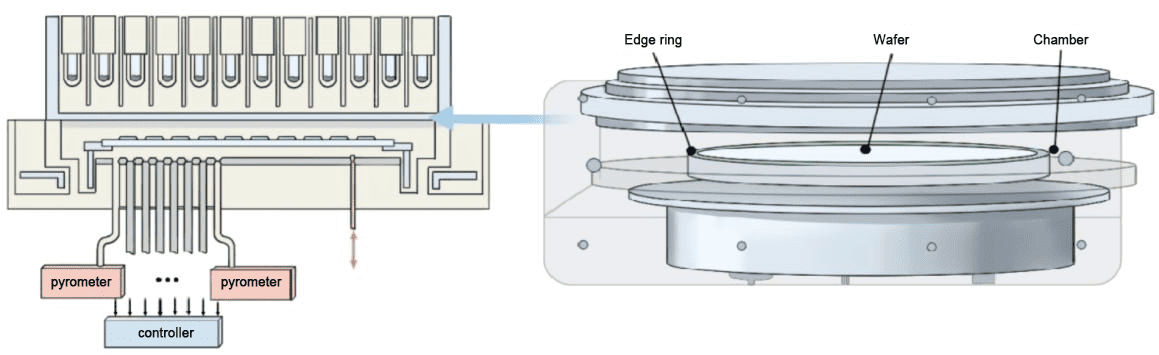
Método de crecimiento epitaxial de fase gaseosa
Gases utilizados en equipos epitaxiales:
● Las fuentes de silicio más utilizadas son SiH4, SiH2Cl2, SiHCl3 y SiCL4. Entre ellos, el SiH2Cl2 es un gas a temperatura ambiente, fácil de usar y tiene una temperatura de reacción baja. Es una fuente de silicio que se ha ido ampliando paulatinamente en los últimos años. SiH4 también es un gas. Las características de la epitaxia de silano son una baja temperatura de reacción, sin gases corrosivos y puede obtener una capa epitaxial con una distribución pronunciada de impurezas.
● SiHCL3 y SICL4 son líquidos a temperatura ambiente. La temperatura de crecimiento epitaxial es alta, pero la tasa de crecimiento es rápida, fácil de purificar y segura de usar, por lo que son fuentes de silicio más comunes. SICL4 se usó principalmente en los primeros días, y el uso de SiHCL3 y SiH2CL2 ha aumentado gradualmente recientemente.
● Dado que la △ h de la reacción de reducción de hidrógeno de fuentes de silicio como SICL4 y la reacción de descomposición térmica de SiH4 es positiva, es decir, aumentar la temperatura es propicio para la deposición de la silicio, el reactor debe calentarse. Los métodos de calentamiento incluyen principalmente calentamiento por inducción de alta frecuencia y calentamiento por radiación infrarroja. Por lo general, un pedestal hecho de grafito de alta pureza para colocar sustrato de silicio se coloca en un cuarzo o una cámara de reacción de acero inoxidable. Para garantizar la calidad de la capa epitaxial de silicio, la superficie del pedestal de grafito está recubierta con SIC o se deposita con una película de silicio policristalina.
Fabricantes relacionados:
● Internacional: CVD Equipment Company de Estados Unidos, GT Company de Estados Unidos, Soitec Company de Francia, AS Company de Francia, Proto Flex Company de Estados Unidos, Kurt J. Lesker Company de Estados Unidos, Applied Materials Company de Estados Unidos.
● China: 48.º Instituto del Grupo de Tecnología Electrónica de China, Qingdao Sairuida, Hefei Kejing Materials Technology Co., Ltd.,Deals Semicondutor Technology Co., Ltd, Beijing Jinsheng Micronano, Jinan Liguan Electronic Technology Co., Ltd.
Aplicación principal:
El sistema de epitaxia en fase líquida se utiliza principalmente para el crecimiento epitaxial en fase líquida de películas epitaxiales en el proceso de fabricación de dispositivos semiconductores compuestos, y es un equipo de proceso clave en el desarrollo y producción de dispositivos optoelectrónicos.
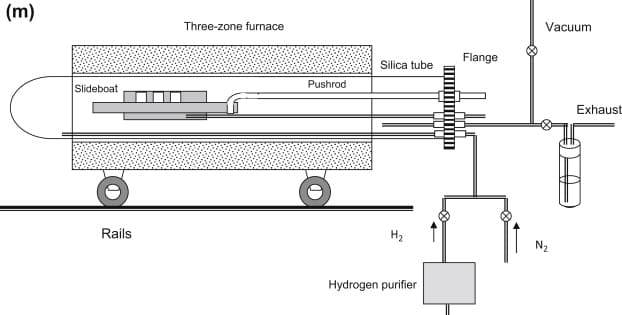
Características técnicas:
● Alto grado de automatización. A excepción de la carga y descarga, todo el proceso se completa automáticamente por el control de la computadora industrial.
● Las operaciones de proceso pueden ser completadas por manipuladores.
● La precisión de posicionamiento del movimiento del manipulador es inferior a 0,1 mm.
● La temperatura del horno es estable y repetible. La precisión de la zona de temperatura constante es mejor que ±0,5 ℃. La velocidad de enfriamiento se puede ajustar dentro del rango de 0,1 a 6 ℃/min. La zona de temperatura constante tiene buena planitud y buena linealidad de pendiente durante el proceso de enfriamiento.
● Función de refrigeración perfecta.
● Función de protección integral y confiable.
● Alta confiabilidad del equipo y buena repetibilidad del proceso.
Vetek Semiconductor es un fabricante y proveedor profesional de equipos epitaxiales en China. Nuestros principales productos epitaxiales incluyenSusceptor de barril recubierto de SIC CVD, Susceptor de barril recubierto de SiC, Susceptor de barril de grafito recubierto de SIC para EPI, Susceptor Epi de oblea con revestimiento de SiC CVD, Soporte giratorio de grafito, etc. Vetek Semiconductor se ha comprometido durante mucho tiempo a proporcionar tecnología avanzada y soluciones de productos para el procesamiento epitaxial de semiconductores, y admite servicios de productos personalizados. Esperamos sinceramente convertirnos en su socio a largo plazo en China.
Si tiene alguna consulta o necesita detalles adicionales, no dude en ponerse en contacto con nosotros.
Móvil/WhatsAPP: +86-180 6922 0752
Correo electrónico: anny@veteksemi.com



+86-579-87223657


Wangda Road, Ziyang Street, condado de Wuyi, ciudad de Jinhua, provincia de Zhejiang, China
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co., Ltd. Reservados todos los derechos.
Links | Sitemap | RSS | XML | política de privacidad |
