Código QR

Sobre nosotros
Productos
Contáctenos

Teléfono

Fax
+86-579-87223657

Correo electrónico

DIRECCIÓN
Wangda Road, Ziyang Street, condado de Wuyi, ciudad de Jinhua, provincia de Zhejiang, China
Los sustratos de carburo de silicio tienen muchos defectos y no se pueden procesar directamente. Se debe cultivar una película delgada de un solo cristal específica en ellas a través de un proceso epitaxial para hacer obleas de chips. Esta película delgada es la capa epitaxial. Casi todos los dispositivos de carburo de silicio se realizan en materiales epitaxiales. Los materiales epitaxiales homogéneos de carburo de silicio de alta calidad son la base para el desarrollo de dispositivos de carburo de silicio. El rendimiento de los materiales epitaxiales determina directamente la realización del rendimiento de los dispositivos de carburo de silicio.
Los dispositivos de carburo de silicio de alta corriente y alta fielabilidad han presentado requisitos más estrictos en la morfología de la superficie, la densidad de defectos, la uniformidad de dopaje y espesor de los materiales epitaxiales. Densidad de gran talla, de baja definición y alta uniformidadepitaxia de carburo de siliciose ha convertido en la clave para el desarrollo de la industria del carburo de silicio.
La preparación de alta calidadepitaxia de carburo de silicioRequiere procesos y equipos avanzados. El método de crecimiento epitaxial de carburo de silicio más ampliamente utilizado es la deposición de vapor químico (CVD), que tiene las ventajas de control preciso del grosor de la película epitaxial y la concentración de dopaje, menos defectos, tasa de crecimiento moderada y control automático de procesos. Es una tecnología confiable que se ha comercializado con éxito.
La epitaxia de CVD de carburo de silicio generalmente utiliza equipos de CVD de pared caliente o pared caliente, lo que garantiza la continuación de la capa de cristal de la capa epitaxial 4H en condiciones de temperatura de crecimiento más altas (1500-1700 ℃). Después de años de desarrollo, la CVD de pared caliente o pared cálida se puede dividir en reactores horizontales de estructura horizontal y reactores de estructura vertical vertical de acuerdo con la relación entre la dirección del flujo de gas de entrada y la superficie del sustrato.
La calidad del horno epitaxial de carburo de silicio tiene principalmente tres indicadores. El primero es el rendimiento del crecimiento epitaxial, incluida la uniformidad del espesor, la uniformidad de dopaje, la tasa de defectos y la tasa de crecimiento; El segundo es el rendimiento de la temperatura del equipo en sí, incluida la velocidad de calefacción/enfriamiento, temperatura máxima, uniformidad de temperatura; y finalmente el rendimiento de costos del equipo en sí, incluido el precio unitario y la capacidad de producción.
CVD horizontal de pared caliente, CVD planetario de pared caliente y CVD vertical de pared cuasi-caliente son las soluciones de tecnología de equipos epitaxiales convencionales que se han aplicado comercialmente en esta etapa. Los tres equipos técnicos también tienen sus propias características y pueden seleccionarse según las necesidades. El diagrama de la estructura se muestra en la figura a continuación:

El sistema CVD horizontal de la pared caliente es generalmente un sistema de crecimiento de tamaño de gran tamaño impulsado por la flotación y rotación del aire. Es fácil lograr buenos indicadores en la administración. El modelo representativo es PE1O6 de LPE Company en Italia. Esta máquina puede realizar la carga y descarga automática de obleas a 900 ℃. Las características principales son la alta tasa de crecimiento, el ciclo epitaxial corto, la buena consistencia dentro de la oblea y entre hornos, etc. Tiene la mayor cuota de mercado en China.

Según los informes oficiales de LPE, combinados con el uso de usuarios principales, los productos de obleas epitaxiales 4H-SIC de 100-150 mm (4-6 pulgadas) 4H-SIC con un espesor de menos de 30 μm producidos por el horno epitaxial PE1O6 pueden lograr de manera intensiva los siguientes indicadores: espesor epitaxial intra-wafer que no es uniforme, no uniformidad ≤2%, ≤2%, ≤2%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5%, ≤5. ≤1cm-2, área libre de defectos de la superficie (celda unitaria de 2 mm × 2 mm) ≥90%.
Empresas nacionales como JSG, CETC 48, Naura y NASO han desarrollado equipos epitaxiales de carburo de silicio monolítico con funciones similares y han logrado envíos a gran escala. Por ejemplo, en febrero de 2023, JSG lanzó un equipo epitaxial SIC de dos obras de 6 pulgadas. El equipo utiliza las capas superior e inferior de las capas superiores e inferiores de las partes de grafito de la cámara de reacción para cultivar dos obleas epitaxiales en un solo horno, y los gases de proceso superior e inferior pueden regularse por separado, con una diferencia de temperatura de ≤5 ° C, lo que constituye efectivamente la desventaja de la capacidad de producción de la capacidad de producción monolítica de los hornos horizontales de la clave.Sic recubrimiento de la media luna. Estamos suministrando piezas de media luna de 6 y 8 pulgadas a los usuarios.

El sistema CVD planetario de pared caliente, con una disposición planetaria de la base, se caracteriza por el crecimiento de múltiples obleas en un solo horno y alta eficiencia de salida. Los modelos representativos son el equipo epitaxial de AIXG5WWC (8x150 mm) y G10-SIC (9 × 150 mm o 6 × 200 mm) equipos epitaxiales de Aixtron de Alemania.
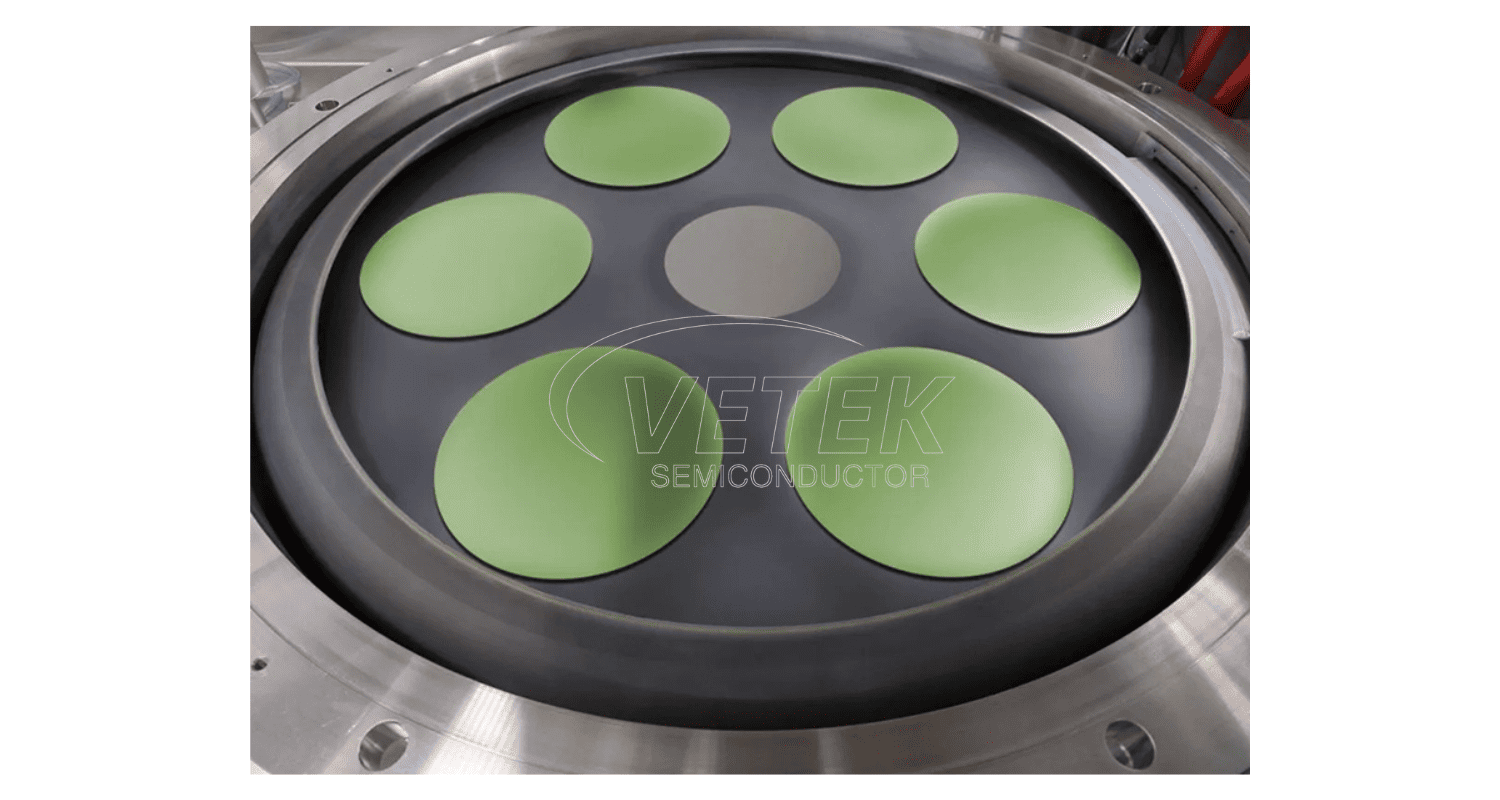
Según el informe oficial de Aixtron, los productos de obleas epitaxiales 4H-SIC de 6 pulgadas con un grosor de 10 μm producido por el horno epitaxial G10 pueden lograr de manera estable los siguientes indicadores: desviación de espesor epitaxial entre obras de ± 2.5%, espesor epitaxial intraavexial no uniformidad de 2%, una desventada de concentración de doping intermediante de ± 5%de espesor intervidor de ± 5%, de espesor de 2%, intervianza de ± 5%, de espesor de 2%, interviante de la concentración de la concentración de la concentración de la concentración intermedia, de la concentración de la concentración de la concentración de la concentración de la concentración intermedia. concentración no uniformidad <2%.
Hasta ahora, este tipo de modelo rara vez es utilizado por usuarios nacionales, y los datos de producción por lotes son insuficientes, que en cierta medida restringe su aplicación de ingeniería. Además, debido a las altas barreras técnicas de los hornos epitaxiales múltiples en términos de campo de temperatura y control de campo de flujo, el desarrollo de equipos domésticos similares todavía está en la etapa de investigación y desarrollo, y no existe un modelo alternativo. Mientras tanto, podemos proporcionar un susceptor planetario de Aixtron como 6 pulgadas y 8 pulgadas con recubrimiento TAC o SIC.
El sistema CVD vertical cuasi-hot de la pared vertical gira principalmente a alta velocidad a través de asistencia mecánica externa. Su característica es que el grosor de la capa viscosa se reduce efectivamente por una menor presión de la cámara de reacción, aumentando así la tasa de crecimiento epitaxial. Al mismo tiempo, su cámara de reacción no tiene una pared superior en la que se pueden depositar partículas SIC, y no es fácil producir objetos que caen. Tiene una ventaja inherente en el control de defectos. Los modelos representativos son los hornos epiRevos6 y Epirevos8 de una sola vela de la nuflare de Japón.
Según Nuflare, la tasa de crecimiento del dispositivo Epirevos6 puede alcanzar más de 50 μm/h, y la densidad de defectos de la superficie de la oblea epitaxial se puede controlar por debajo de 0.1 cm -ie; En términos de control de uniformidad, el ingeniero de Nuflare Yoshiaki Daigo informó los resultados de uniformidad intra-wafer de una oblea epitaxial de 6 pulgadas de 10 μm de espesor cultivada con Epirevos6, y el grosor intra-wafer y la no uniformidad de la concentración de dopaje alcanzaron el 1% y 2.6% respectivo.Cilindro de grafito superior.
En la actualidad, los fabricantes de equipos nacionales, como Core Third Generation y JSG, han diseñado y lanzado equipos epitaxiales con funciones similares, pero no se han utilizado a gran escala.
En general, los tres tipos de equipos tienen sus propias características y ocupan una cierta cuota de mercado en diferentes necesidades de aplicación:
La estructura de CVD horizontal de la pared caliente presenta una tasa de crecimiento ultra rápida, calidad y uniformidad, operación y mantenimiento de equipos simples, y aplicaciones de producción madura a gran escala. Sin embargo, debido al tipo de objeto único y el mantenimiento frecuente, la eficiencia de producción es baja; El CVD planetario de pared cálido generalmente adopta una estructura de la bandeja de 6 (pieza) × 100 mm (4 pulgadas) o 8 (pieza) × 150 mm (6 pulgadas), que mejora en gran medida la eficiencia de producción del equipo en términos de capacidad de producción, pero es difícil controlar la consistencia de múltiples piezas, y el rendimiento de producción es el problema más grande; El CVD vertical de pared cuasi-caliente tiene una estructura compleja, y el control de defectos de calidad de la producción de obleas epitaxiales es excelente, lo que requiere una experiencia de mantenimiento y uso de equipos extremadamente ricos.
Tasa de crecimiento rápida
simple estructura de equipos y
mantenimiento conveniente
Gran capacidad de producción
alta eficiencia de producción
Buen control de defectos del producto
Cámara de reacción larga
ciclo de mantenimiento
Estructura compleja
difícil de controlar
consistencia del producto
Estructura de equipo complejo,
Mantenimiento difícil
Representante
equipo
fabricantes
CVD horizontal de pared caliente
CWD planetario de pared cálido
CTD vertical de pared cuasi-hot
Ventajas
Desventajas
Ciclo de mantenimiento corto
Italia LPE, Japón Tel
Alemania Aixtron
Japón Nuflare
Con el desarrollo continuo de la industria, estos tres tipos de equipos se optimizarán y actualizarán de manera iterativamente en términos de estructura, y la configuración del equipo será cada vez más perfecta, desempeñando un papel importante en la coincidencia de las especificaciones de las obleas epitaxiales con diferentes espesores y requisitos de defectos.



+86-579-87223657


Wangda Road, Ziyang Street, condado de Wuyi, ciudad de Jinhua, provincia de Zhejiang, China
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co., Ltd. Reservados todos los derechos.
Links | Sitemap | RSS | XML | política de privacidad |
