Código QR

Sobre nosotros
Productos
Contáctenos

Teléfono

Fax
+86-579-87223657

Correo electrónico

DIRECCIÓN
Wangda Road, Ziyang Street, condado de Wuyi, ciudad de Jinhua, provincia de Zhejiang, China
AguafuerteLa tecnología es uno de los pasos clave en el proceso de fabricación de semiconductores, que se utiliza para eliminar materiales específicos de la oblea para formar un patrón de circuito. Sin embargo, durante el proceso de grabado en seco, los ingenieros a menudo encuentran problemas como el efecto de carga, el efecto de micro-ranura y el efecto de carga, que afectan directamente la calidad y el rendimiento del producto final.
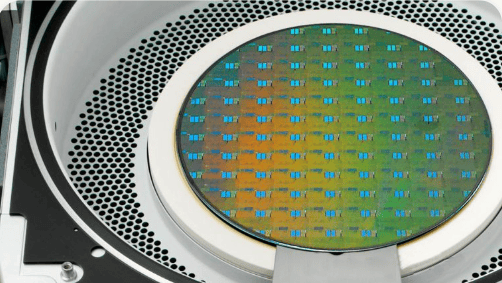
El efecto de carga se refiere al fenómeno de que cuando el área de grabado aumenta o la profundidad del grabado aumenta durante el grabado en seco, la velocidad de grabado disminuye o el grabado es desigual debido a un suministro insuficiente de plasma reactivo. Este efecto suele estar relacionado con las características del sistema de grabado, como la densidad y uniformidad del plasma, el grado de vacío, etc., y está ampliamente presente en varios grabados con iones reactivos.
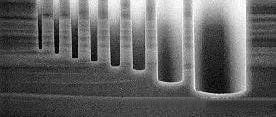
•Mejorar la densidad del plasma y la uniformidad: Al optimizar el diseño de la fuente de plasma, como mediante el uso de potencia de RF más eficiente o tecnología de pulverización catódica con magnetrón, se puede generar un plasma de mayor densidad y más uniformemente distribuido.
•Ajustar la composición del gas reactivo: Agregar una cantidad apropiada de gas auxiliar al gas reactivo puede mejorar la uniformidad del plasma y promover la descarga efectiva de subproductos de grabado.
•Optimizar el sistema de vacío: Mejorar la velocidad de bombeo y la eficiencia de la bomba de vacío pueden ayudar a reducir el tiempo de residencia de los subproductos de grabado en la cámara, reduciendo así el efecto de carga.
•Diseñar un diseño de fotolitografía razonable: Al diseñar el diseño de la fotolitografía, se debe tener en cuenta la densidad del patrón para evitar una disposición excesivamente densa en áreas locales para reducir el impacto del efecto de carga.
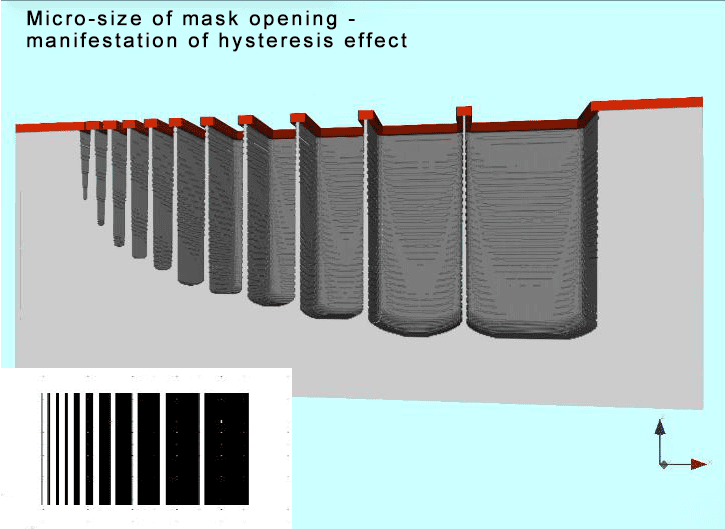
El efecto de micro-breve se refiere al fenómeno que durante el proceso de grabado, debido a las partículas de alta energía que golpean la superficie de grabado en un ángulo inclinado, la velocidad de grabado cerca de la pared lateral es más alta que la del área central, lo que resulta en no -Vevericales Chamfers en la pared lateral. Este fenómeno está estrechamente relacionado con el ángulo de las partículas incidentes y la pendiente de la pared lateral.
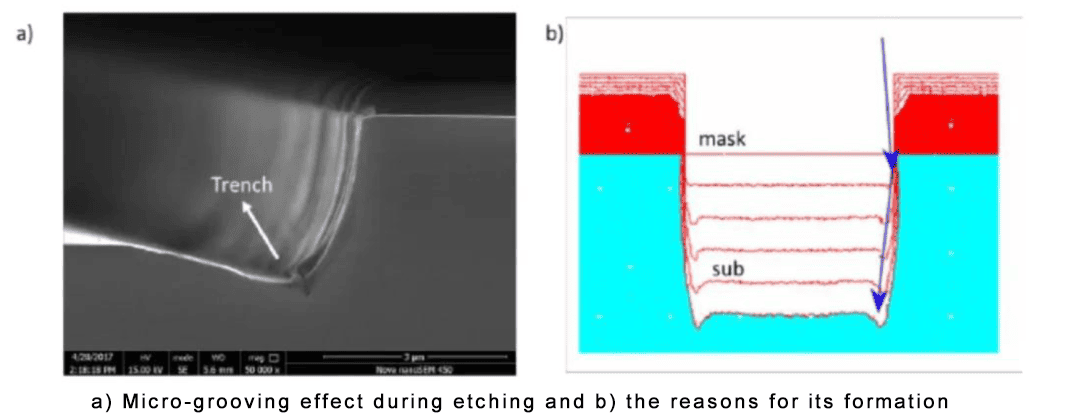
•Aumentar la potencia de RF: Aumentar adecuadamente la potencia de RF puede aumentar la energía de las partículas incidentes, lo que les permite bombardear la superficie objetivo más verticalmente, reduciendo así la diferencia de la velocidad de grabado de la pared lateral.
•Elija el material de máscara de grabado adecuado: Algunos materiales pueden resistir mejor el efecto de carga y reducir el efecto de micro-trifrado agravado por la acumulación de carga negativa en la máscara.
•Optimizar las condiciones de grabado: Al ajustar finamente los parámetros, como la temperatura y la presión durante el proceso de grabado, la selectividad y la uniformidad del grabado se pueden controlar de manera efectiva.
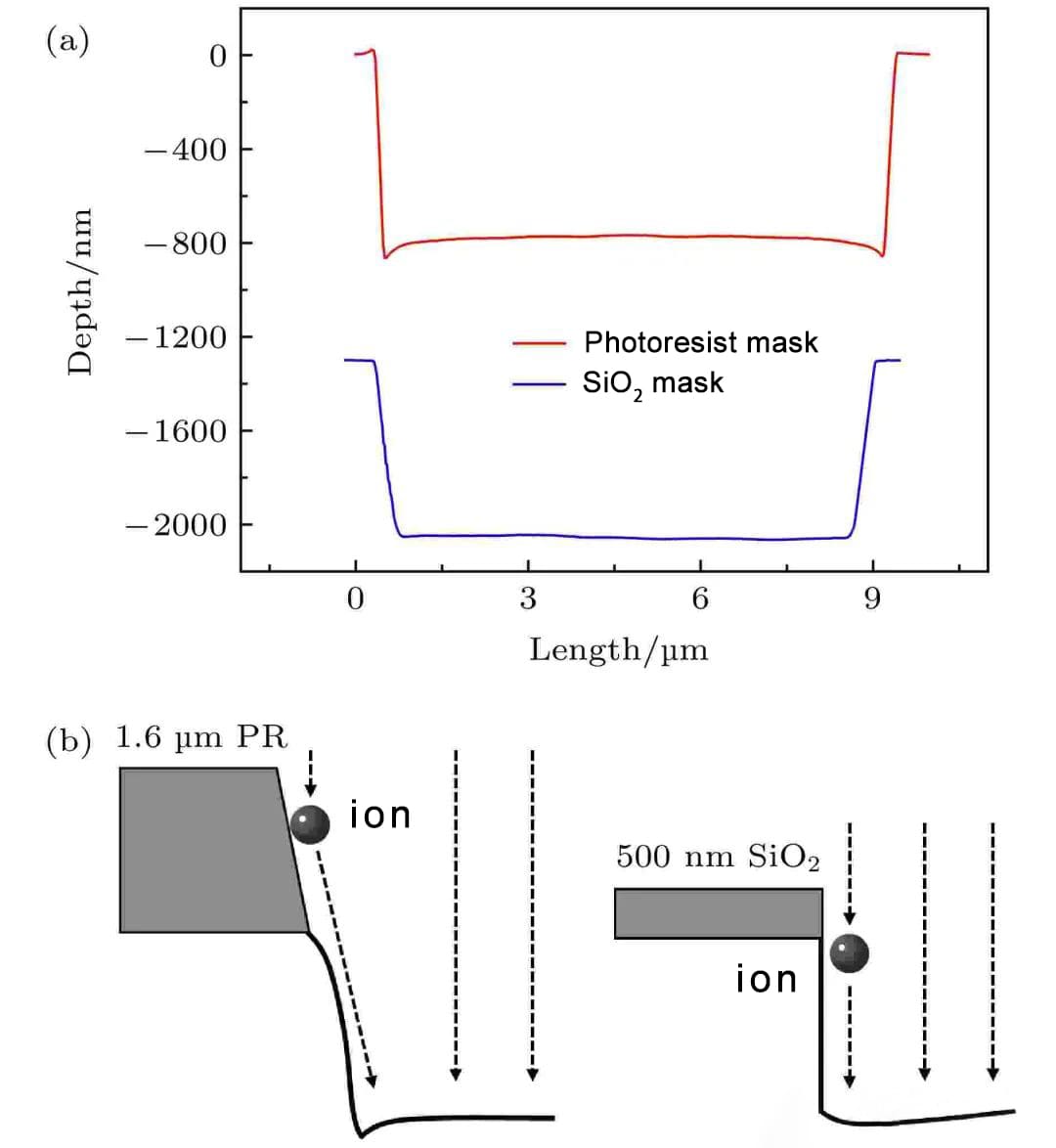
El efecto de carga es causado por las propiedades aislantes de la máscara de grabado. Cuando los electrones en el plasma no pueden escapar rápidamente, se reunirán en la superficie de la máscara para formar un campo eléctrico local, interferirán con el camino de las partículas incidentes y afectarán la anisotropía del grabado, especialmente al grabar estructuras finas.
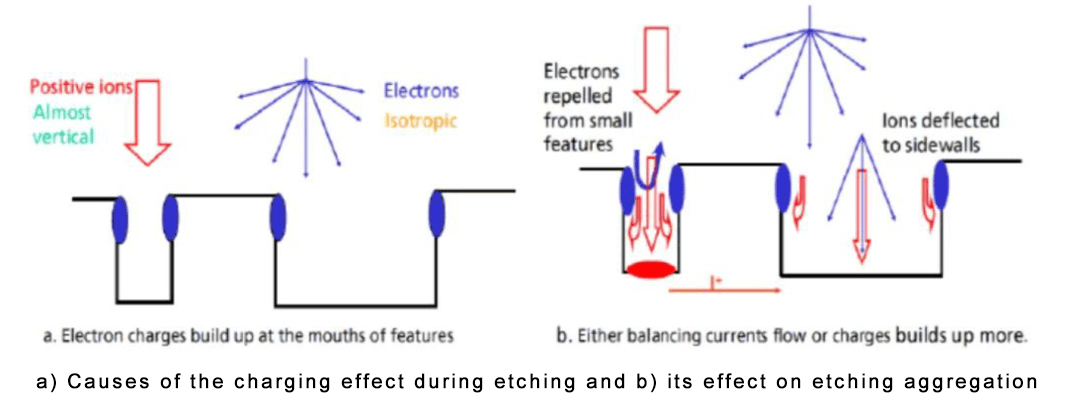
• Seleccione materiales de máscara de grabado adecuados: Algunos materiales especialmente tratados o capas de máscaras conductoras pueden reducir efectivamente la agregación de electrones.
•Implementar grabado intermitente: Al interrumpir periódicamente el proceso de grabado y dar a los electrones el tiempo suficiente para escapar, el efecto de carga puede reducirse significativamente.
•Ajustar el entorno de grabado: Cambiar la composición del gas, la presión y otras condiciones en el entorno de grabado pueden ayudar a mejorar la estabilidad del plasma y reducir la aparición del efecto de carga.
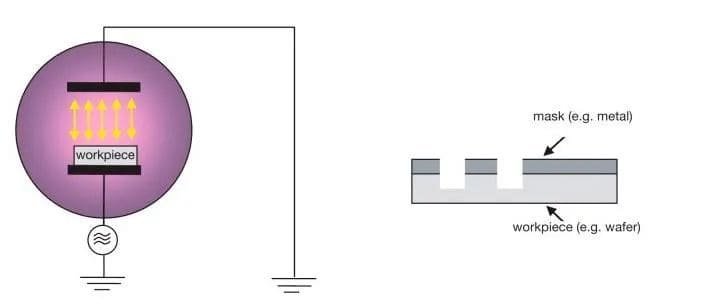



+86-579-87223657


Wangda Road, Ziyang Street, condado de Wuyi, ciudad de Jinhua, provincia de Zhejiang, China
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co., Ltd. Reservados todos los derechos.
Links | Sitemap | RSS | XML | política de privacidad |
